

当晶圆翘曲遇见光学测量,一家韩国公司的“亚微米级”解法
在『半导体』制造的世界里,有一句行话:“无法测量,就无法制造。”
当摩尔定律放缓,先进封装和异构集成成为延续『芯片』性能提升的关键路径,3D堆叠、混合键合、硅通孔(TSV)等技术让『芯片』结构从“二维平面”走向“三维立体”。但一个致命的问题随之而来:如何精准测量这些微米级甚至纳米级的立体结构?
晶圆翘曲(Warp/Bow)如何影响光刻对准?微凸点高度不一致如何导致键合失效?多层膜厚度偏差如何影响电性能?这些问题的答案,都指向同一个关键设备——3D光学测量传感器。
今天,我们要介绍的,正是这家来自韩国大田、在光学测量领域深耕多年的专业厂商——韩国Nexensor(耐神) 。
一、看得见的趋势,看不见的难题
先进封装时代的“测量焦虑”
根据TechInsights预测,2025年全球晶圆测量设备市场规模将达76亿美元💵,其中在线3D测量是增长最快的细分领域。
为什么增长如此迅猛?因为先进封装带来了三大测量难题:
第一,高深宽比结构。 TSV的深宽比可达20:1,传统2D显微镜🔬无法测量垂直方向的深度和侧壁形貌。
第二,反射率差异过大。一块晶圆上,既有强反射的金属焊盘(如铜、铝),又有弱反射的介质层(如氧化硅、氮化硅)。传统共焦显微镜🔬面对这种“明暗悬殊”的样品,往往难以一次准确成像 。
第三,透明/半透明多层膜。 晶圆表面的钝化层、光刻胶、低k介质层,厚度偏差直接影响器件性能,但常规测量手段难以穿透膜层、精准定位界面。
更棘手的是晶圆翘曲。随着晶圆从8英寸走向12英寸,从硅基走向化合物(碳化硅、氮化镓),多层异质材料堆叠带来的应力导致晶圆翘曲越来越严重。翘曲过大,光刻机无法对焦,键合机无法对准——整条产线可能因此停摆。
二、一家韩国公司的“光学武器库”
就在这样的行业背景下,位于韩国大田广域市(韩国“硅谷”,科研重镇)的Nexensor公司,凭借多年光学测量技术积累,构建了一套覆盖多种测量场景的“光学武器库”。
Nexensor的核心定位非常清晰:专注3D光学测量传感器的专业研发与生产 。他们的技术路线覆盖四大方向:





差异化优势何在?
Nexensor的独特之处在于,它能同时覆盖“纳米级精度”(白光干涉)和“大面积快速”(DMD结构光)两个维度。这意味着客户无需在不同设备之间切换,就能完成从微观结构到宏观翘曲的全方位测量 。
更重要的是,Nexensor的解决方案专为产线在线检测设计。“1秒扫描速度”、“实时数据获取”、“适用于大规模生产线”等关键词,反复出现在他们的产品介绍中 。对于追求高良率和高节拍的晶圆厂和封测厂而言,这无疑是极具吸引力的价值主张。
目前,Nexensor的客户已覆盖三星、LG、HB Technology、Hyundai Mobis、Autonics等知名企业,在『半导体』和显示面板行业积累了丰富的应用经验 。
三、深潜一项技术:当“HDR”遇见光学测量
如果说产品矩阵是Nexensor的“骨骼”,那么核心技术就是它的“灵魂”。
在一篇2024年发表于 《IEEE Photonics Technology Letters》 的论文中,Nexensor的研究人员(Chang-Soo Kim)与韩国科学技术院(KAIST)团队合作,提出了一种基于并行共焦检测的高动态范围(HDR)彩色体积成像技术。
这项技术解决的是什么问题?
传统共焦显微镜🔬在面对反射率差异过大的样品时,会遇到一个两难困境:
- 如果曝光时间设置得太短,弱反射区域(如介质层)会“一片漆黑”,无法成像;
- 如果曝光时间设置得太长,强反射区域(如金属焊盘)会“过曝饱和”,细节丢失。
一块晶圆上,金属与介质并存,明暗差异可达几个数量级——传统方法往往需要多次扫描、分别成像,再后期合成,效率低下且精度受损。
Nexensor的解法:像相机📷️的HDR模式
Nexensor提出的方案,可以通俗地理解为给光学显微镜🔬装上了 “HDR模式”。
具体来说:
1. 并行共焦检测:通过将图案投影到物体上,并使用焦点可调透镜进行轴向扫描,快速获取体积轮廓数据。
2. 光源功率调制:与轴向扫描方向同步,动态调制光源功率。一次扫描采用高功率(照亮暗区),一次扫描采用低功率(避免亮区过曝)。
3. 双轮廓融合:将两次扫描获得的体积轮廓融合,重建出一个高动态范围的完整3D轮廓 。
实际价值是什么?
即使样品表面既有强反射的金属凸点,又有弱反射的介质层,Nexensor的技术也能一次扫描、全看清。对于晶圆级封装中的微凸点检测、RDL(重布线层)形貌测量等场景,这项技术意味着更高的检测效率和更可靠的测量结果。
四、从实验室到产线:Nexensor的实战能力
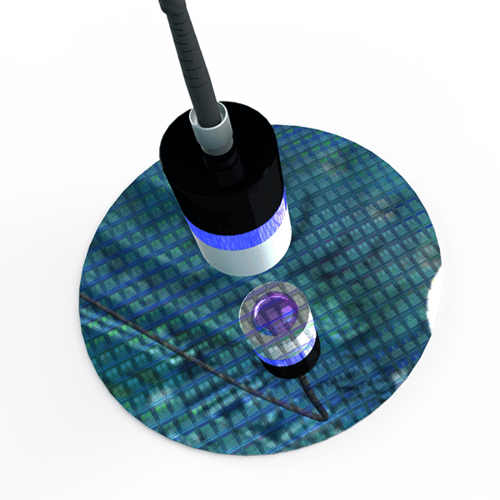
技术终归要落地到产线。Nexensor的产品矩阵,几乎覆盖了『半导体』制造和先进封装领域的所有关键测量需求。
案例1:12英寸晶圆翘曲测量(nXF-3)
晶圆翘曲是先进封装的头号难题。nXF-3采用相位偏折术原理,专门用于测量高反射或透明产品(如裸晶圆、薄膜)的翘曲和弯曲。它是“世界上第一个使用偏光测量法实现这一目标的商用产品”之一 。
关键参数:测量仅需几秒,Z向精度可达1微米,特别适合在大批量检测中保证高节拍和高精度 。
案例2:微凸点3D测量(nXI-5)
在微凸点(Micro Bump)和铜柱的检测中,高度一致性和共面性直接影响键合良率。nXI-5采用白光干涉技术,可测量微米以下的小区域,Z向重复精度达10nm级别 。
更重要的是,它内置实时多层薄膜分离算法,能精确测量多层结构产品的表面形貌和膜厚 。
案例3:晶圆厚度测量(nXV-1)
nXV-1采用近红外干涉原理,单探头即可穿透晶圆测量厚度,无需双面对准 。它可测量透明产品(薄膜、玻璃)和不透明产品(硅晶圆、蓝宝石)的厚度,适用于二次电池密封厚度、PCB保形涂层等场景,最多可安装16个通道的探针,满足多点多参数在线检测需求 。
案例4:大面积快速翘曲/缺陷检测(nXM-1 / nXP-1)
nXM-1采用DMD结构光技术,视场最大可达310mm×310mm,可一次完成12英寸晶圆或大尺寸面板的翘曲测量 。nXP-1更进一步,仅需一张影像即可测量晶圆表面缺陷、透明表面气泡等,真正实现“one-shot”实时检测 。
五、测量,是为了更好地制造
在Nexensor的官网上,有这样一句话:“准确的测量结果将成为AI大数据的基础。”
这揭示了一个更深的逻辑:在智能制造时代,测量设备不仅是“质检员”,更是数据采集的“传感器”。每一片晶圆的翘曲数据、每一颗凸点的高度数据、每一层薄膜的厚度数据,最终都将汇入工艺控制系统,成为优化良率、提升效率的基石。
深圳市捷美德科技有限公司不仅为客户提供全系3D光学测量产品,更致力于提供面向『半导体』、显示面板、PCB、『新能源』电池等领域的测量解决方案。
当您的产线遇到以下问题:
- 晶圆翘曲影响光刻对准?
- 微凸点高度一致性难以把控?
- 多层膜厚度偏差找不到根源?
- 高反射/透明表面测不准?
不妨联系我们。因为有时候,解决问题的钥匙,就藏在“精准测量”这四个字里。
)
)
)


)
)
)
进行酰胺化反应)
)
)
)
)
)
)
)