
随着AI大模型、高性能计算的快速发展,HBM高带宽内存、高端AI『芯片』、Chiplet异构集成成为『半导体』产业的核心方向,摩尔定律的演进已从平面微缩转向3D垂直集成。而晶圆键合,正是实现3D『芯片』、异质材料集成、先进封装的核心支柱工艺。在晶圆键合过程中,晶圆的高精度对准是决定工艺成败、『芯片』性能、量产良率的防控线,先进键合工艺的对准精度要求正在向更高的精度迈进。哪怕仅有几纳米的对准偏差,都会导致『芯片』报废、器件性能失效与可靠性降低。而实现纳米级对准的核心,正是能帮助晶圆调整位姿的压电纳米定位台。
一、晶圆键合技术
1.晶圆键合(Wafer Bonding)是『半导体』前道制造与先进封装的核心工艺,是一种将两片或多片晶圆(如硅、SiC、GaN等材料)在分子或原子尺度实现一体化结合的技术。晶圆键合的主要目的是突破传统『芯片』制造在二维平面上的物理极限,实现更高性能、更低功耗和更多功能的集成,例如:
(1)3D集成:垂直堆叠不同功能的『芯片』,显著提升集成度与数据传输速度;
(2)异质集成:将不同材料的晶圆(如GaN、Si等)无缝结合在一起,实现优势互补
(3)先进封装:制备SOI晶圆、MEMS真空腔体等特殊结构,通过晶圆级封装大幅提升量产良率,降低制造成本。
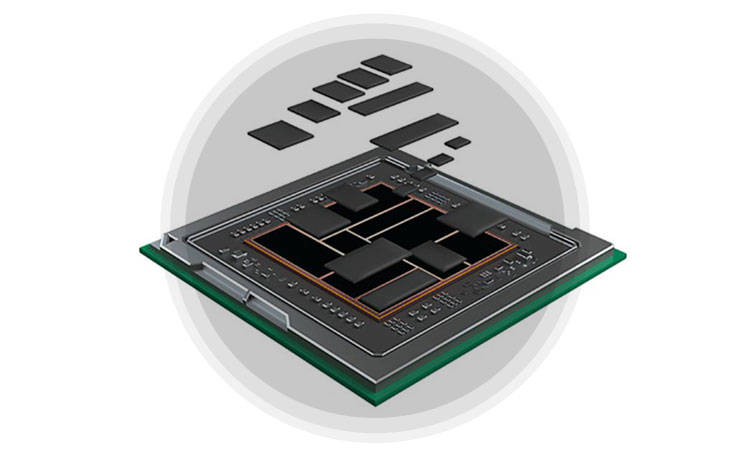 (注:图片来源于网络)
(注:图片来源于网络)
2.典型的晶圆键合过程包含以下关键步骤:
(1)表面预处理:通过化学清洗、等离子体活化等工艺,使晶圆表面原子级平整,去除杂质与缺陷;
(2)精确对准:将两片晶圆上的对准标记精确重合,以确保后续电气连接的正确性;
(3)预键合:将两片对准的晶圆贴合在一起,利用分子间作用力使晶圆初步贴合;
(4)退火强化:通过高温加热使原子间形成牢固的共价键,从而将两片晶圆永久性地结合在一起;
(5)质量检测:检测键合强度、对准精度与可靠性。
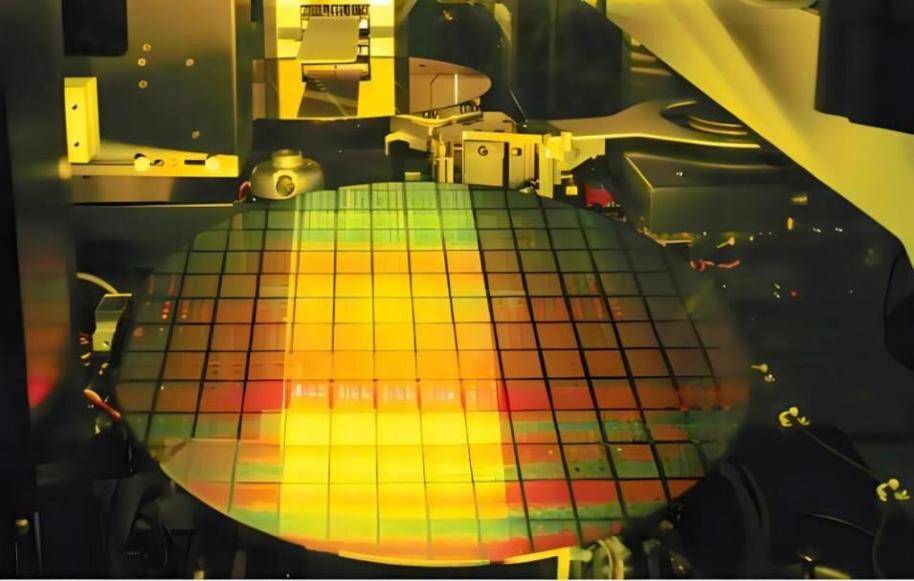 (注:图片来源于网络)
(注:图片来源于网络)
3.晶圆键合的核心技术指标:对准精度
在晶圆键合的诸多技术指标中,对准精度是决定最终『芯片』功能与性能的最关键参数之一。
对准精度直接关系到:电气互联的成效、『芯片』性能的优劣、生产良率与成本。
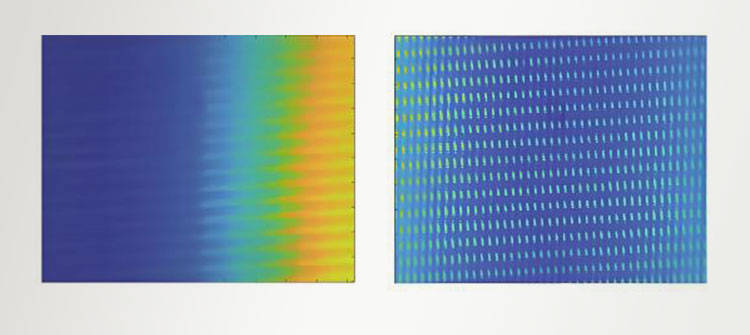 (注:图片来源于网络)
(注:图片来源于网络)
二、压电纳米定位台:晶圆对准的核心执行单元
晶圆精对准的本质,是对晶圆的位置进行纳米级的精确调整。压电纳米定位台是以压电陶瓷作为驱动源,结合柔性铰链机构实现多轴精密运动的压电平台。其核心优势在于体积小、无摩擦、响应速度快,配置高精度传感器后,可实现纳米级分辨率及定位精度,且具有极高的可靠性。
在晶圆键合过程中,压电纳米定位台通过多自由度微动,补偿误差,将晶圆调整到理想的对准位置。这一过程需要同时满足高精度、高稳定性、快响应等要求,压电纳米定位台凭借独有的驱动与结构特性,是晶圆键合对准调姿的核心标配部件。
芯明天压电纳米定位台的核心技术优势
(1)纳米级定位精度
压电纳米定位台通过逆压电效应实现电信号到位移的直接转换,分辨率和定位精度可达纳米级,完全满足先进晶圆键合对亚微米乃至纳米级对准的要求。
(2)毫秒级快速响应
压电纳米定位台的响应时间通常在毫秒级,可实时补偿位移偏差。在晶圆键合过程中,压电纳米定位台能够快速完成晶圆位置的微调,避免因调整滞后导致的对准失败。
(3)无摩擦
压电纳米定位台采用无摩擦柔性铰链机构设计,具有零间隙传动、高导向精度、高分辨率、长期稳定等优势。
(4)多轴协同运动能力
晶圆对准需要同时调整多个自由度,包括多轴直线及旋转,而压电纳米定位台可实现三维甚至六自由度的精密运动。
(5)高稳定性与可靠性
压电纳米定位台的高刚性、零间隙的设计保证了系统在操作中的稳定性和重复性,是承载晶圆的可靠平台。
产品推荐
芯明天H30系列压电纳米定位台是具有中心通孔的、XY直线及θz轴旋转运动的三维压电偏摆台,采用无摩擦柔性铰链结构设计,响应速度快、闭环定位精度高,可满足晶圆对准过程中的调整需求。
 芯明天H30系列压电纳米定位台
芯明天H30系列压电纳米定位台
技术参数

晶圆键合对位纳米台
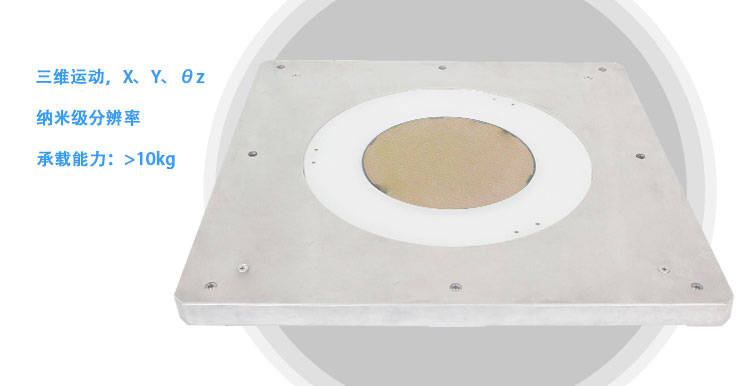 芯明天晶圆键合对位纳米台
芯明天晶圆键合对位纳米台
技术参数
运动自由度:X、Y、θz
行程:XY>100μm/轴、θz>0.2mrad
纳米级分辨率
承载能力:>10kg
可选真空版本
产品可定制
)
)
)
)
)



)

)
)
)
)
)
)